我院在纳米集成电路测试领域取得新进展
发布时间:2020-08-11 发布人:管理员
当集成电路的特征尺寸达到纳米级,加工过程中在器件表面的纳米污染物颗粒将严重影响集成电路的良品率。国际上, 半导体制造技术战略联盟 (SEMATECH)和IEEE国际半导体技术发展蓝图2020 (IEEE IRDS 2020)对纳米集成电路加工中的污染物颗粒浓度均有明确限定和迫切的测试需求,然而目前满足这一需求的在线检测技术仍未得到解决。
近日,我院系统结构研究室实现了一种用于IC工艺清洗液中超痕量纳米污染物检测的先进传感器,将纳米流体富集与传感器pF级界面电容测量相结合,可达到102 particles/mL的检测限,传感器响应时间短至30秒。对于粒径为10nm的污染物颗粒,线性检测区间达(102~ 107) particles/mL,性能达到已报导相关技术的领先水平。该传感器及检测方案是简便、实时且无损的,可满足实际IC工艺中的在线良率提升的技术需求。

在线发表的图形化摘要
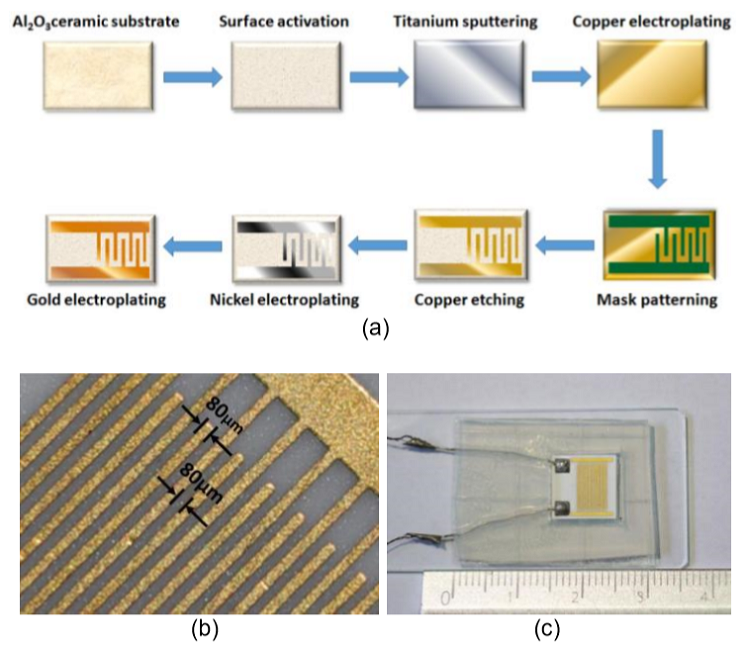
传感器制备流程及器件照片
该工作在线发表于电子电气类和传感器领域知名期刊IEEE Sensors Journal (Early Access), 第一作者为戚昊琛老师,梁华国教授为论文通信作者,美国田纳西大学Jayne Wu教授为论文共同通信作者,合肥工业大学为论文第一单位。该工作得到了国家自然科学基金、安徽省自然科学基金等项目的资助。







